�ŘO�^���Ӻ���Դ�ӳ��e��ˇ�ă�(y��u)����TFT���Ե�Ӱ��о�
����ͨ�^�����ٳ��e�ĖŘO�^����(GL��)�͵��ٳ��e����Դ��(AL��)�ı�Ĥ���e�l���M���˃�(y��u)���������˳��eAL�ӵĹ��ʣ��g��ȗl����׃������Ĥ�ij��e���ʺ;����Ե�Ӱ푣�����@Щ��ˇ�l����Ion��Ӱ푵ı��|(zh��)���_����ѵij��eAL�ӵij��e�l�����{(di��o)����GL�ӵĹ��ʺ�NH3�����������˃��ߌ�Ion��Ӱ�Ҏ(gu��)�ɲ������˃�(n��i)�ڵ�ԭ��ͨ�^���ȃ�(y��u)��ǰ��ı�Ĥ���w��(TFT)���������l(f��)�F(xi��n)��Ion������32%���_�P��(Ion/Ioff)�����˼s40%���_���˃�(y��u)��TFT���Ե�Ŀ�ġ�
����Ŀǰ��Һ���@ʾ��(LCD)�����䃞(y��u)�����@ʾƷ�|(zh��)���p������ȡ����ͨ��ꎘO�侀��(CRT)�@ʾ�������ڴ���e�@ʾ��LCD��������Դ�����һ�N���^������x����Դ���LCD���õ��DZ�Ĥ���w��(TFT)��У���TFT�����Ҫʹ��a-Si��H����TFT�ϵ�������a-Si��H���d�����w�����^�ͣ���TFT�����������_·��B(t��i)�µ�����^�ͣ��ȶྦྷ��ҪС2��3����(sh��)��������M����Ҫ����Ҫ�Mһ������a-Si��H��TFT���ԡ����⣬���ښ仯�Ǿ���(a-Si��H)��Ĥ���ڱ��^���ȱ���ܶȣ�����TFT�е�a-Si��H��Ĥ��SiNx��Ĥ֮�g���ڱ��^�����B(t��i)��ʹ��a-Si��HTFT�ڹ��T�������ŘO늉��������£��������_·���Ion��˥�˺��yֵ늉�������TFT�����Ԯa(ch��n)��һ����Ӱ푣�������ڌ��H���a(ch��n)�^���У��������a(ch��n)�ܺ���TFT���ԵĽǶȁ����]��һ�㌢�ŘO�^����(GL��)����Դ��(AL��)�֞�ɲ��M�г��e����һ������ٳ��e��(GH�Ӻ�AH��)�������e���ռ������ȵĽ^�֣���Ĥ�ӽY(ji��)��(g��u)�^���ɣ����Һ����^���ȱ�ݣ��ڶ�������ٳ��e��(GL�Ӻ�AL��)���@�Ɍ�λ�ږŽ^���Ӻ�a-Si��H�ӵĽ���̎�����e���^�ͣ�Ĥ�ӽY(ji��)��(g��u)�^���ܣ�ȱ���١����˸���a-Si��H��TFT����������Ion��ˮƽ�����Č�GL�Ӻ�AL�ӵij��e�l���M���˃�(y��u)������K�_��Ion������Ҫ��
1�����
�������IJ��õIJ�������ߴ�Ҏ(gu��)���1100mm×1300mm���ŘO�^����(SiNx)�͚仯�Ǿ����(a-Si��H)�ij��e����AKT-15K���x���w�������W������e(PECVD)ϵ�y(t��ng)���B�m(x��)��ɵġ�PECVD�O��ľ��w����(sh��)�飺���������(y��u)��1.33Pa���������w��SiH4��NH3��N2�Ț��w�M�����ɣ������w�ľ��w������SiH4��������1.69��3.38Pa·l/s��NH3��������6.76��10.14Pa·l/s��N2��������16.9��30.42Pa·l/s���仯a-Si����SiH4�ֽⷽʽ���ɣ�����SiH4������1.69��5.07Pa·l/s��H2������11.83��20.28Pa·l/s��SiNx���e���ʞ�3000��6000W��a-Si���e���ʞ�500��2300W�����e�ضȞ�300��400�棬�≺��133��333Pa��
�����D1��PECVD�O�䷴��ǻ�w����D��ʾ��D���ڳ��e���^���У�Ӱ푱�Ĥ���|(zh��)��������Ҫ�����O��Ĝضȡ��ɘO��֮�g�ľ��x�����ʺ͚��w���ʵ����P���ء�
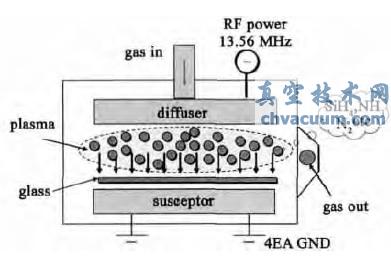
�D1 PECVD�O�䷴��ǻ�w�Ľ���ʾ��D
�����������wͨ�^���S��С�M�ɵĔUɢ��(diffuser)���뷴��ǻ�w�У���ϵ�y(t��ng)�г��e�ŘO�^���ӣ�ͨ�^һϵ�еĻ��W�������ɖŘO�^����(SiNx)����Դ��(a-Si)�����l(f��)������Ҫ��������

��������ᘌ�AL�ӵ�SiH4��H2�������������g���Լ������OӋ��5����2ˮƽ��1/4�IJ������ӌ��_����AL������Ion����ѵij��e�l������AL�ӵ���ѵij��e�l���Ļ��A�ϣ��OӋGL�ӵ�NH3�������ʵ�ȫ���ӌ�
3���Y(ji��)Փ
��������ͨ�^��AL�Ӻ�GL�ӵij��e�l���M���˃�(y��u)���������˱�Ĥ�������Ժ̓ɌӵĽ���B(t��i)��������AL�ӵĹ��ʣ��g���׃������Ĥ�ij��e���ʺ;����Ե�Ӱ푣�����@Щ��ˇ�l����Ion��Ӱ푵ı��|(zh��)��ͨ�^GL�ӵĹ��ʺ�NH3������ȫ���ӌ���ʾ�˸��軯��SiNx��Ĥ�������GL�Ӻ�AL�ӵľ���ƥ��ȣ��p���˽���B(t��i)������������TFT��Ion�������˹��ʌ�Ion��Ӱ�Ҏ(gu��)�ɣ�ͨ�^���ȃ�(y��u)��ǰ���TFT���������l(f��)�F(xi��n)���l����׃�����˃�(y��u)��TFT���Ե�Ŀ�ġ�