TiO2/SiOxNy/SiO2�ӯB�Y���Ž��|�����-늉������о�
��������ӑՓ�������l�ſ؞R�����Ҫ��ˇ�Ƃ��TiO2/SiOxNy/SiO2 �Y����k �Ž��|���������cӑՓ�˲�ͬ�ɷֽ���SiOxNy ��Ĥ�����£��Ž��|���w���- 늉����ԵĮ�ͬ����Փ����SiO2 ������ڱ��C�Ž��|����늌W���ܷ�������á�
�������ˑ���SiO2 �Ž��|�����p����������©늺��ܺĆ��}���ı����o�_ʼ�����ҽ�늳�������SiO2 �ĸ�k �Ž��|���ϳ��˰댧�w�I��һ���о����c�����������늌W�����Ե����ƣ����ш���ĸ�k �����ھC��늌W���ܷ��涼����⣬������Ҋ���õĸ�k ���϶��Ը߳ɱ���ˇ�l������A����ͨ�^�������ϱ����߽�늳������ݵē��s���Է����팍�F������TiO2�@����^�߽�늳������ҹ�ˇ�ɱ��^�͵IJ���Ҳ���C�����ܷ���IJ���o���õ��ƏV��
���������ԌӯB�Y���Ž��|��ͻ�ƿڣ����⁹���Ž��|�о��������ó��e��TiO2 ���r��֮�g��SiO2 ��SiOxNy (SION)�ӯB�Y�����污Ĥ������TiO2 �Ž��|늌W���ܣ����w�Y�����Ա�ʾ��늘O/TiO2/SiOxNy/SiO2/Si�����������- 늉����Ԟ�������c�����ƏVTiO2 ��Ĥ��MOS �Ž��|�I��đ��õ춨���A��
1�����
����MOS ��Ĥ����Ƃ�������ʞ�4 Ωcm~7Ωcm��p �͆ξ�Si(100)����ף������ƌ��ƽ�_���M�н��|Ĥ�ĞR����e��늘OĤ�����l���e������������ݰ���������N�Y����Al/TiO2/SiOxNy_1 (����)/SiO2/Si(�Y��A)��Al/TiO2/SiOxNy_2(����)/SiO2/Si(�Y��B)��Al/TiO2/Si(�Y��C)��Al/TiO2/SiO2/Si(�Y��D)��Al/TiO2/SiOxNy/Si(�Y��E)���Y��A �ͽY��B �DZ��ĵ��о����c��������SION ��Ĥ����SION��Ĥ����������̽ӑ����̎��ͬSION ��Ĥ�ɷ���Ȍ�������w���ܵ�Ӱ푣��������N�Y���t����ǰ���о����A�Ͻo���ı��^�ӱ����Y��C��D��E ���Ƃ������cǰ���о�[10]һ�£����污Ĥ�Թ�О�Դ�M�з����R�䣬�R�书�ʾ���500 W���������w�����քe��SiO2��QAr(���)��9.5 sccm��QO(����)��1.0 sccm;SiOxNy��QAr ��9.5 sccm��QO ��1.0 sccm��QN(����)��1.0 sccm��TiO2 �������l�R�䷨���e�����Ƶõ�TiO2 ��Ĥ��늳�������50~70��
�����Y��A �ͽY��B ���ڱ��CSiO2 �Ƃ乤ˇ��׃����r�£����벻ͬ�ɷֵ�SION ���污Ĥ�����w���F�r����ͨ�^��ͬ�ĞR����w������Ȍ��F��Ĥ�ɷֿ��ơ�SiOxNy(����)Ĥ�ӌ�����������1.6 sccm����������1.0 sccm �ķ������w�M�ϗl����ͨ�^�����R���Ƶã��C��ǰ�ڹ����YՓ�͔���ɷַ��������˗l���¿Ɍ���Ĥ��ԭ�ӱ���(O/(O+N))������0.85~0.95��SiOxNy(����)Ĥ�ӌ�����������0.4 sccm����������1.0 sccm �ķ������w�M�ϗl����ͨ�^�����R���Ƶã��˗l���¿Ɍ���Ĥ��ԭ�ӱ���������0.25~0.35��
�������˽���ˇ��ʩ�^��������s�|�x�ӵ�Ӱ푣����ǰ�����ϵ�y�M���˸��bʹ�ø��Y����ݿ����ڱ�����ՠ�B��׃�ėl����ͨ�^ԭλ�Q���M�и��ӽ��|Ĥ��늘OĤ�ij��e�����ڳ��e���M����N2 ����˻����ޏ�ˇȱ�ݡ��D1��TiO2/SiOxNy/SiO2 �Y���ĵ���TEM ����Y���D���@ʾ���^�����ķ�Ч�������Ž��|�Ĝyԇ�Ը��l���- 늉����Ԝyԇ(HP4294A ƽ�_)�������Է������еĽ��|�ӽ������ԡ�

�D1 TiO2/SiOxNy/SiO2/Si �Y������Y���D
2��C-V ����ӑՓ
������MOS �Ž��|늌W���ܵ��о���Ҫͨ�^���������- 늉�(C- V) �������֡��D2 ����1MHz �l�ʗl�������Y������M�Мyԇ�õ��ĵ���C- V �����D����ʾ���ֵ��������֮�e�ۑB��ݞ�������˚wһ��̎����������ݻ��מ�p�͆ξ��裬���ȷ����ɖŽ��|늺������ؓ�ʼn�����C- V ����ƫ�ơ���D2 ��ʾ��C �Y����ݵ�C- V ����ƫ��������f�������ĖŽ��|늺��ܶ����[5]���Y��A��B ��D��E �������Ėʼn�Ư�Ƅt���^�������ͬ�r��ӳ����څ���njӯB�Y��������ƫ����С�چΌӽ�����|������ƫ�����������浪�ɷ�Խ�ߣ��䌦����ƫ����ҲԽС���f���˽Y��SION ���污Ĥ�ČӯB�Y�������Ɩʼn�ƫ�Ʒ�����@�����á�
������һ���棬�����Y����������Ľ���EPMA�ɷַ����������Y��C �п������r����̎��Ti�ɷ���ߣ��_����5%��������Ԇμ�SiO2 ������ĽY��D���_����2.1%����SiOxNy ������ӵĽY��E ��Ti ������1.1%�����Y��A �Ľ���Ti �������ٞ�1.0%������ͬ�Ӳ��ÏͺϽ���Y���ĽY��B(����Ti ������1.3%)�͆Ό�SION ����ĽY��E���������Ti �ɷֵij��F��ҪԴ�ڹ�ˇ�^����TiO2 �ɷ�����r����ͬ�̶ȵĔUɢ�����������������@ʾ���Uɢ�̶Ⱥ�SION �ڽ�����ռ��������ֱ���Pϵ�ģ���C- V �yԇ�Y���У�Ҳֱ�ӱ��F�鲻ͬ�̶ȵĖʼn�ƫ������
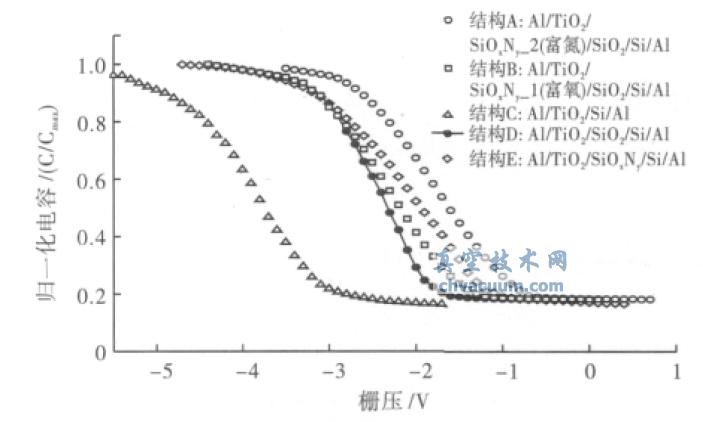
�D2 ���Y��MOS ��ݵ����- 늉�(C- V)��������
����SION Ĥ����������Ti ����Uɢ�����ã����ӯB�Y����SION Ĥ�Ӻ�SiO2 Ĥ���ڽ���ČӯB�M��Ҳ��һ���̶��Ͻ����˵��ɷֵĽ���BЧ�������鷴ӳ����늌W�|������һ��ָ�ˣ����^�D2 ��C- V ���������ķe��- �����^�Ʌ^б�ʿ�֪���Y��C ��C- V �����������^�Ʌ^�^�L�����F���^����늉��S������չ���^�͵�б�ʡ��Y��A��B ��E �������^�Ʌ^��늉��S�ϵ���չ�L�����������б��Ҳ�����ڽY��C����A��B��E �����Іμ�SION ��Ĥ������ĽY��E �t�@ʾ����͵��^�Ʌ^б�ʡ������Y���������Y����SiO2 Ĥ�Ӻ�ČӯB���|(�Y��A��B)��Ч������SION Ĥ���е��ɷ֎����Ľ���B���}�������|���õ����@���ơ����Y��A �ͽY��B ��б����Ȼ���چμ�SiO2 ������ĽY��D���ɴ˿�Ҋ���������ý����|����SiO2 ��Ĥ�ڌӯB�Y������һ������ȱ�ٵĽ�ɫ��
3���YՓ
��������ͨ�^��C- V ���Ե��������Փ�C�˽Y��SiOxNy ��Ĥ�ČӯB�Y���ڸ���⁹��MOS �Ž��|�C�����ܷ���ă��ݣ��Լ�һ�㹤ˇ�l���£�SiO2 Ĥ���ڸ��Ƹ�k ���|늌W���ܷ������Ҫ���ã��������Mһ�����M��k ���|���о������á�
ȫ�����d��
����TiO2/SiOxNy/SiO2�ӯB�Y���Ž��|�����-늉������о�